美國 KRi 霍爾離子源不規則電子晶片蒸鍍前清洗
上海伯東美國 KRi 霍爾離子源 EH 400 成功應用于蒸發鍍膜機, 協助客戶完成不規則電子晶片蒸鍍前清洗, 經過清洗后的晶片鍍膜, 膜層厚度均勻性及附著牢固度都明顯提高.
KRi 霍爾離子源在不規則電子晶片蒸鍍中的作用
設備: 進口蒸發鍍膜機, 加裝離子源
離子源型號: KRi 霍爾離子源 EH 400
預清潔應用: 通過離子 Ar 轟擊晶片表面, 去除物理或化學吸附的污染物, 清潔后在進行蒸鍍, 膜層厚度均勻性及附著牢固度都明顯提高.
去除物理吸附污染: 去除晶片表面污染, 如水, 吸附氣體, 碳氫化合物殘留
去除化學吸附污染: 去除天然和粘合材料. 如表面氧化物, 通常去除 < 100?
美國 KRi 霍爾離子源 eH 400 特性
高離子束電流滿足沉積率的臨界到達比
低離子能量通過避免高能離子對表面和界面的轟擊損傷而使產量更大化
寬束, 發散離子束通過均勻地覆蓋沉積區從而增加每次加工零件數量來提高吞吐量
堅固耐用的模塊化結構降低了備件耗材和維護時間, 減少維護成本和停機時間
無柵網, 緊湊設計, 方便加裝, 提供離子輔助功能
KRi 霍爾離子源 eH 400 技術參數:
型號 | eH 400 |
陽極 | DC |
陽極電流 | 5A |
離子束流 | >750mA |
陽極電壓范圍 | 40-300V |
離子能量范圍 | 25-300eV |
陽極功率 | 500W (輻射冷卻) |
氣體 | 惰性氣體和反應氣體 |
氣體流量 | 3-30 sccm |
壓力 | < 1 x 10-3 Torr |
離子束流直徑 | 4cm Φ |
離子束發散角度 | > 45° (hwhm) |
陰極中和器 | 沉浸式或非沉浸式 |
高度 | 3.0” (7.62cm) |
直徑 | 3.7” (9.4cm) |
上海伯東代理美國 KRi 離子源適用于安裝在 MBE 分子束外延, 濺射和蒸發系統, PLD 脈沖激光系統等, 在沉積前用離子轟擊表面, 進行預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等! 上海伯東是美國 KRi 離子源中國總代理
1978 年 Dr. Kaufman 博士在美國創立 Kaufman & Robinson, Inc 公司, 研發生產考夫曼離子源, 霍爾離子源和射頻離子源. 美國考夫曼離子源歷經 40 年改良及發展已取得多項成果. KRi 離子源在真空環境中實現薄膜沉積, 干式納米刻蝕和修改材料表面性能, 廣泛用于離子清洗 PC, 離子蝕刻 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 領域.
若您需要進一步的了解 KRi 離子源, 請參考以下聯絡方式
上海伯東: 羅小姐
免責聲明
- 凡本網注明“來源:化工儀器網”的所有作品,均為浙江興旺寶明通網絡有限公司-化工儀器網合法擁有版權或有權使用的作品,未經本網授權不得轉載、摘編或利用其它方式使用上述作品。已經本網授權使用作品的,應在授權范圍內使用,并注明“來源:化工儀器網”。違反上述聲明者,本網將追究其相關法律責任。
- 本網轉載并注明自其他來源(非化工儀器網)的作品,目的在于傳遞更多信息,并不代表本網贊同其觀點和對其真實性負責,不承擔此類作品侵權行為的直接責任及連帶責任。其他媒體、網站或個人從本網轉載時,必須保留本網注明的作品第一來源,并自負版權等法律責任。
- 如涉及作品內容、版權等問題,請在作品發表之日起一周內與本網聯系,否則視為放棄相關權利。
 手機版
手機版 化工儀器網手機版
化工儀器網手機版
 化工儀器網小程序
化工儀器網小程序
 官方微信
官方微信 公眾號:chem17
公眾號:chem17
 掃碼關注視頻號
掃碼關注視頻號












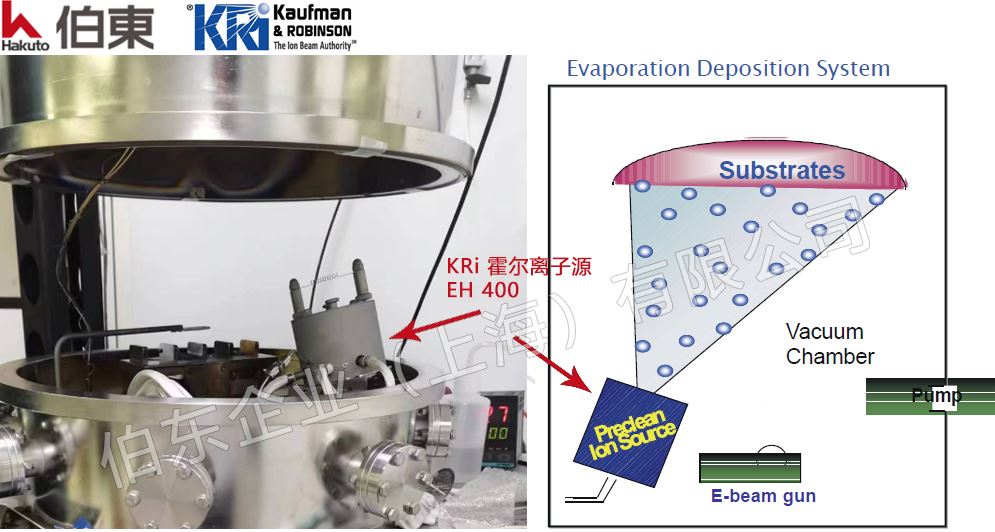







 采購中心
采購中心